| [1] |
王晨辉, 陈伟, 刘岩, 等. 基区表面势对栅控横向PNP晶体管中子位移损伤的影响[J]. 强激光与粒子束, 2015, 27:114002. (Wang Chenhui, Chen Wei, Liu Yan, et al. Influence of base surface potential on neutron displacement damage of gate-controlled lateral PNP bipolar transistors[J]. High Power Laser and Particle Beams, 2015, 27: 114002 doi: 10.11884/HPLPB201527.114002
|
| [2] |
Gorelick J L, Ladbury R, Kanchawa L, et al. The effects of neutron irradiation on gamma sensitivity of linear integrated circuits[J]. IEEE Trans Nucl Sci, 2004, 51(6): 3679-3685. doi: 10.1109/TNS.2004.839245
|
| [3] |
李兴冀. 星用双极型器件带电粒子辐照效应及损伤机理[D]. 哈尔滨: 哈尔滨工业大学, 2010: 37-66.Li Xingji. Radiation effects and damage mechanisms caused by charged particles on bipolar devices used for space craft. Harbin: Harbin Institute of Technology, 2010: 37-66
|
| [4] |
刘超铭. 双极晶体管辐射损伤效应及深能级缺陷研究[D]. 哈尔滨: 哈尔滨工业大学, 2013: 98-135.Liu Chaoming. Radiation damage effects and deep level defects in bipolar junction transistor. Harbin: Harbin Institute of Technology, 2013: 98-135
|
| [5] |
Barnaby H J, Smith S K, Schrimpf R D, et al. Analytical model for proton radiation effects in bipolar devices[J]. IEEE Trans Nucl Sci, 2003, 49(6): 2643-2649.
|
| [6] |
Barnaby H J, Schrimpf R D, Sternberg A L, et al. Proton radiation response mechanisms in bipolar analog circuits[J]. IEEE Trans Nucl Sci, 2001, 48(6): 2074-2080. doi: 10.1109/23.983175
|
| [7] |
Li Xingji, Liu Chaoming, Rui Erming, et al. Simultaneous and sequential radiation effects on NPN transistors induced by protons and electrons[J]. IEEE Trans Nucl Sci, 2012, 59(3): 625-633. doi: 10.1109/TNS.2012.2191572
|
| [8] |
Li Xingji, Geng Hongbin, Liu Chaoming, et al. Combined radiation effects of protons and electrons on NPN transistors[J]. IEEE Trans Nucl Sci, 2010, 57(2): 831-836. doi: 10.1109/TNS.2009.2039355
|
| [9] |
Wang Chenhui, Bai Xiaoyan, Chen Wei, et al. Simulation of synergistic effects on lateral PNP bipolar transistors induced by neutron and gamma irradiation[J]. Nucl Instrum Meth A, 2015.
|
| [10] |
Song Yu, Zhang Ying, Liu Yang, et al. Mechanism of synergistic effects of neutron-and gamma-ray-radiated PNP bipolar transistors[J]. ACS Appl Electron Mater, 2019.
|
| [11] |
Sze S M, Kwok K N. Physics of semiconductor devices[M]. 3rd ed. New York: Wiley-Interscience, 2006.
|
| [12] |
叶迟凡. 晶体管电流放大系数β与集电极电流IC的关系[J]. 怀化师专学报(自然科学版), 1987(5):64-67. (Ye Chifan. The relationship between transistor current amplification factor beta and collector current IC[J]. Journal of Huaihua Teachers College (Natural Science Edition), 1987(5): 64-67
|
| [13] |
Claeys C, Simoen E. Radiation effects in advanced semiconductor materials and devices[M]. Springer-Berlin Heidelberg GmbH, 2002.
|
| [14] |
Kosier S L, Shrimpf R D, Nowlin R N, et al. Charge separation for bipolar transistors[J]. IEEE Trans Nucl Sci, 1993, 40(6): 1276-1285. doi: 10.1109/23.273541
|
| [15] |
Neamen D A. 半导体物理与器件[M]. 4版. 北京: 电子工业出版社, 2013.Neamen D A. Semiconductor physics and devices: basic principles [M]. 4th ed. Beijing: Publishing House of Electronics Industry, 2013
|




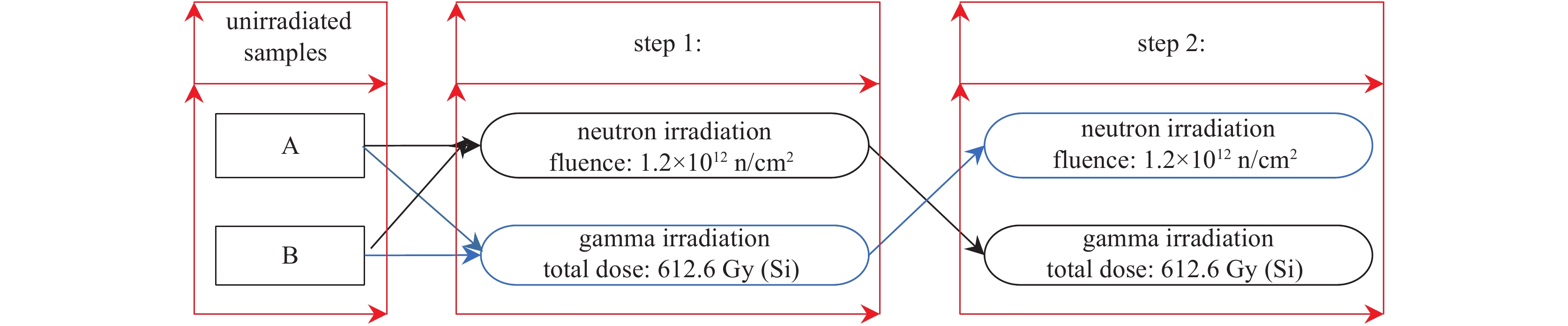
 下载:
下载: